半导体器件的掺杂其实就像做饭一样,需要放入各种调料才能做出色香味俱全,放多了会咸,放少了不入味儿;掺杂就相当于半导体中“添油加醋”的过程和目的。
掺杂,是将一定数量的杂质掺入到半导体材料的工艺,是为了改变半导体材料的电学特性,从而得到所需的电学参数。我们也经常会听到通过改善哪儿哪儿的掺杂浓度来优化某些性能的说法。
掺杂的方法主要有扩散和离子注入,两种方法在分立器件或集成电路中都有用得到,并且两者可以说是互补的,比如说,扩散可应用于形成深结,离子注入可形成浅结。
下面我们就分别来聊聊扩散和离子注入这两种掺杂方式。
一、扩散
杂质扩散一般是将半导体晶片放入精确控制的高温石英管炉中,通过带有需扩散杂质的混合气体而完成,扩散进入半导体的杂质原子数目和混合气体的杂质分压有关。对于硅的扩散而言,常用的温度范围一般在800℃~1200℃,硼是最常用的p型杂质,砷和磷是最常用的n型杂质。这三种元素在硅中的固溶度都比较高,采用的掺入形式有:固相源(如BN、As2O3、P2O5)、液相源(BBr3、AsAl和POCl3)以及汽相源(B2H6、AsH3和PH3),这三种形式之中,液相源使用得最为广泛,下图是液相源石英管炉的结构图:
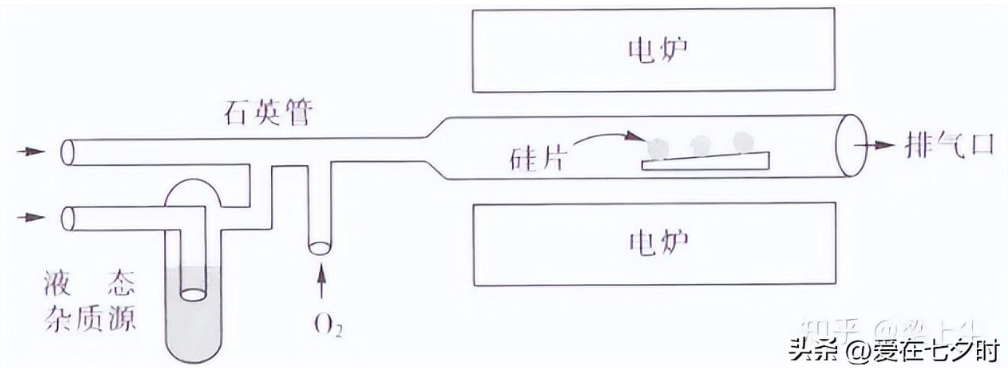
通过氧化反应将磷还原出来并扩散到硅中,而生成的Cl2则被排出。涉及到的反应方程式如下:
4POCl3+3O2→2P2O3+6Cl2
2P2O5+5Si→4P+5SiO3
杂质在半导体中扩散我们可以看成是杂质原子在晶格中以空位或间隙原子形式进行移动。下面我们介绍两种扩散机制:替代式扩散机制和填隙式扩散机制。
■替代式扩散机制

空心圆表示在晶格平衡位置的基质原子,红色实心圆表示杂质原子。在高温下,晶格原子在格点平衡位置附近震动,基质原子有一定的几率获得足够的能量从而脱离格点成为间隙原子,产生一个空位,此时邻近的杂质原子就可以占据这个空位,这就是替代式扩散,也叫空位扩散。
■填隙式扩散机制

如果间隙杂质原子从一个位置运动到另一个位置而且还不占据格点,我们叫这种为填隙式扩散,一般在杂质原子相对于基质原子较小时采用这种运动。
杂质原子的扩散分布和它初始的条件及边界有关。这里简单介绍两种扩散方法,一种是恒定源扩散,从名字我们就知道整个扩散过程杂质源的表面浓度都是保持恒定的;另一种叫有限源扩散,即将一定量的杂质淀积在半导体的表面,接着向半导体内扩散,过程中不再施加任何杂质源。
一般我们在集成电路工艺中采用两步扩散方法:首先在恒定源扩散条件下形成预淀积扩散层,然后再在有限源扩散的条件下进行主扩散,能够更好更精确地得到扩散分布。
扩散工艺结果我们一般会通过特殊的测试方法来评估,有下面三种:结深法、薄层电阻法(四探针方法测)和扩散层的杂质分布(电容电压法,二次离子质谱法SIMS)。
以上只是简单地聊了下扩散的概念以及几种扩散机制和方法,都是比较浅的,深入的那些大家有兴趣可以区深挖一下。下面我们再来聊聊离子注入~
二、离子注入
开篇我们给出了扩散和离子注入的两张图,如果说扩散比较温柔的话,那么离子注入则有点暴力了。从下图(C代表掺杂浓度,x是半导体距离表面的深度)中我们可以看到,掺杂分布再半导体内呈现峰值分布,分布的形状主要取决于掺杂离子的质量以及注入时离子所带有的能量。

离子注入是将具有一定能量的带电离子掺入到硅中,注入能量再1keV到1MeV之间,对应的平均离子分布深度范围是10nm到10um之间。相对于扩散工艺,离子注入的主要好处是能够使得杂质掺入量得到较为精准的控制,保持好的重复性,同时离子注入的加工工艺温度比扩散低。
注入相关的工艺一般有下面几种:多次注入、掩蔽层、倾斜角注入、高能注入以及大电流注入等。
■离子注入的几点用途作用:
①多次注入来形成特殊分布;
②选择适当掩蔽材料和厚度,来阻挡一定比例的入射离子进入衬底;
③倾斜角度注入,来形成超浅结;
④高能注入以形成埋层;
⑤大电流注入用于扩散技术中的预淀积、阈值电压调整以及对SOI应用而言形成的绝缘层(SOI:Silicon-On-Insulator,绝缘衬底上的硅,该技术是在顶层硅和背衬底之间引入了一层埋氧化层)。下面是一个中等能量离子注入系统的框架图:
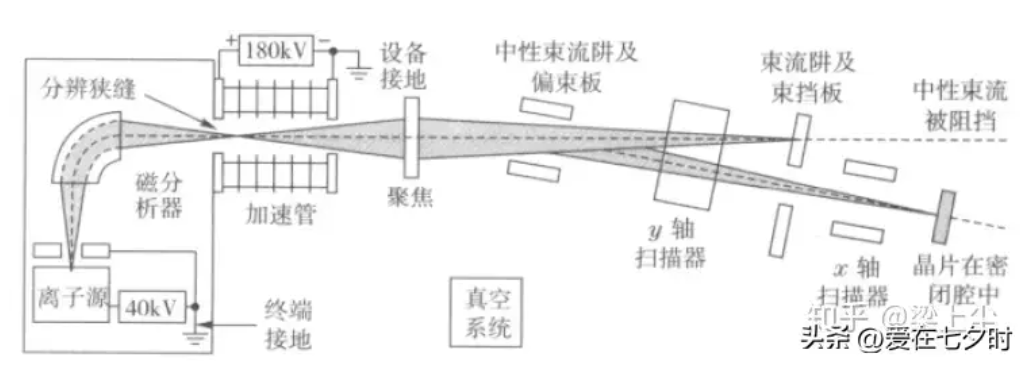
■离子源通过加热分解源气体,使其成为带电离子,加上约40KV的电压,引导这些带电离子移出离子源腔体并进入磁分析器。我们可以通过设定磁分析器的磁场强弱来使得符合要求的离子通过。被选中的离子进入加速管,离子在高压下被加速,从而获得注入时所需的能量。狭缝则是用来确保离子束不会走偏。注入系统内的气压维持在低于十的负四次方帕以下,使得由气体分子引起的离子散射降至最低,再利用静电偏转板使这些离子束扫描整个晶片表面并注入半导体衬底。
高能离子在进入半导体之后,最后会停在晶格内的一定深度。离子注入带来的负面影响主要是由于离子碰撞而导致的半导体晶格断裂或者损伤,所以必须在后续的流程中进行退火处理,来消除这种损伤。
由于高能离子注入之后带来的晶格损伤,会使得半导体的迁移率和寿命等参数受到较为严重的影响,同时,在注入时大部分的离子并不是在替位的位置,为了激活注入离子并恢复迁移率等相关参数,必须在适当的时间和温度下将半导体退火。
(网络资源仅用于课堂教学)


